集成电路的高密度、小型化的需求,使得封装并不能仅局限于对芯片的保护,还需要满足芯片间的信号传输与信号处理的要求。多芯片封装、微系统封装技术因此而被提出。陶瓷封装管壳具有封装密度高、电热性能好,气密性好,可靠性高等特点,在封装领域具有得天独厚的优势。艾邦建有陶瓷封装全产业链微信群,欢迎陶瓷封装产业链上下游加入,请您识别二维码加入。

一、DPC陶瓷管壳的优势特点
表 HTCC、LTCC、DPC工艺对比

(4)低温制备工艺(300℃以下)避免了高温对基片材料和金属线路层的不利影响,同时也降低了生产成本。
二、DPC陶瓷管壳的制备工艺
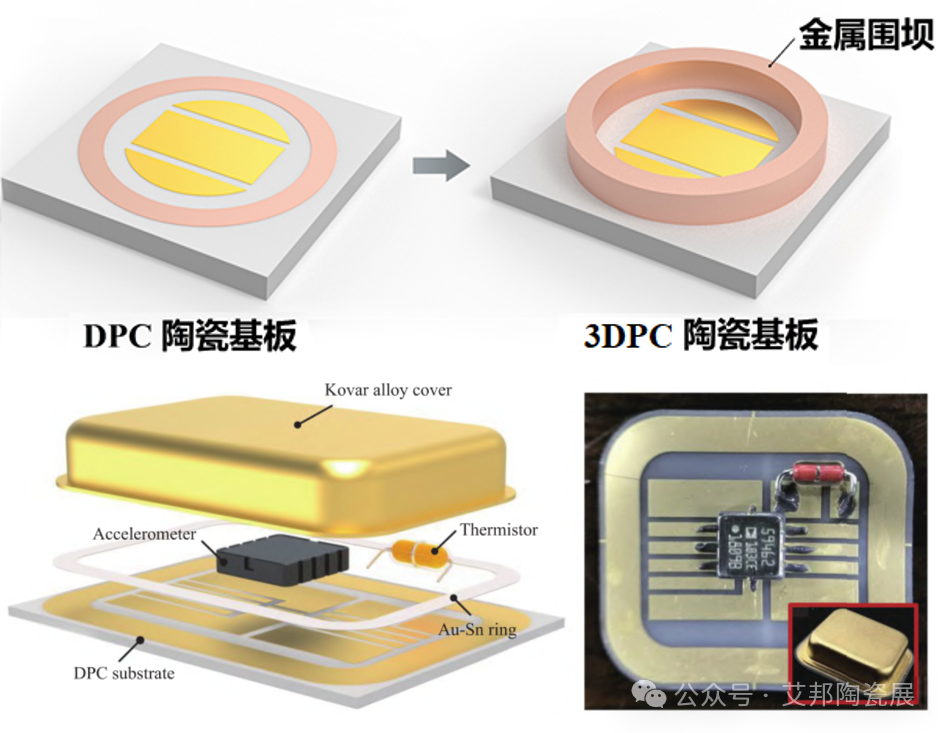
(1)制备陶瓷或金属等材料围坝结构,然后通过胶水胶粘、焊料焊接等工艺,将DPC陶瓷基板与围坝基板对准后,涂覆胶水或填充焊料将围坝与陶瓷基板连接成整体;
(2)直接成型围坝,如采用3D直写和多层镀铜等技术制备得到三维 DPC陶瓷基板,围坝与陶瓷基板间没有键合层结构,直接成型得到。
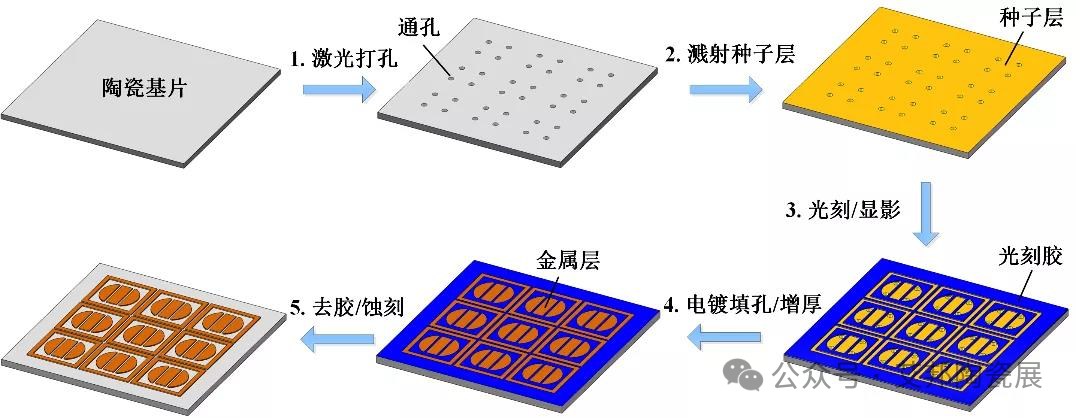
①对陶瓷基片进行激光打孔以形成小孔径通孔(孔径一般为60μm~120μm);
②通过超声清洗陶瓷基片,并利用溅射镀膜工艺在陶瓷基片表面沉积金属种子层(Ti/Cu 靶材);
③利用光刻和显影工艺形成掩膜图形,再利用电镀工艺实现通孔填充和表面铜层增厚;
④通过表面研磨对电镀铜层进行整平,通过表面处理技术(化学镀)形成 Ni/Au层;
⑤去除干膜并蚀刻种子层,完成DPC 陶瓷基板制备;
⑥封装焊接前,对DPC陶瓷基板、可伐盖帽和金锡焊环进行超声波清洗;可伐合金管帽作为封装盖板,通过冲压工艺形成腔体以封装器件;
11月22日,第二届陶瓷封装产业论坛将于石家庄举办,届时,业内知名专家及学者将就 LTCC、HTCC、薄膜工艺、DPC、厚薄膜混合工艺、系统级(SiP)封装等陶瓷封装技术进行探讨,欢迎大家与会交流。演讲&赞助&会议报名请联系李小姐:18124643204(同微信)
艾邦建有陶瓷封装全产业链微信群,欢迎陶瓷封装产业链上下游加入,请您识别二维码加入。

2024年11月22日
|
序号 |
暂定议题 |
演讲嘉宾 |
|
1 |
高可靠封装的机遇与挑战 |
睿芯峰 副总经理 陈陶 |
|
2 |
厚薄膜混合型HTCC工艺技术的开发 |
六方钰成 董事长 刘志辉 |
|
3 |
陶瓷封装技术在半导体器件领域的应用 |
北京大学东莞研究院 郑小平 研究员/项目总监 |
|
4 |
传感器技术的发展及陶瓷封装的应用趋势 |
郑州中科集成电路与系统应用研究院 先进封测中心主管 周继瑞 |
|
5 |
封装用封接玻璃粉的开发 |
天力创 项目经理 于洪林 |
|
6 |
功率模块封装用高强度高热导率Si3N4陶瓷的研究进展 |
中材高新氮化物陶瓷 高级专家 张伟儒 |
|
7 |
高品质氮化硅粉体燃烧合成技术新进展 |
中国科学院理化技术研究所/中科新瓷 高级工程师/总经理 杨增朝 |
|
8 |
钙钛矿型铁电介质陶瓷开发及应用 |
电子科技大学 唐斌 教授 |
|
9 |
电子封装陶瓷基板关键的制备技术 |
河北东方泰阳 |
|
10 |
低温共烧陶瓷基板及其封装应用 |
中电科43所 董兆文 研究员 |
|
11 |
系统级封装(SiP)用陶瓷基板技术研发与产业化 |
华中科技大学/武汉利之达科技 教授/创始人 陈明祥 |
|
12 |
薄膜技术在电子封装中的应用 |
七星华创微电子 工程师 任凯 |
|
13 |
超快激光AOD技术颠覆HTCC/LTCC精密钻孔 |
德中(天津)技术 战略发展与市场总监 张卓 |
|
14 |
集成电路陶瓷封装外壳仿真设计 |
拟邀请陶瓷封装厂商/高校研究所 |
|
15 |
陶瓷封装结构优化及可靠性分析 |
拟邀请陶瓷封装厂商/高校研究所 |
|
16 |
陶瓷封装平行缝焊工艺与技术 |
拟邀请陶瓷封装/设备厂商/高校研究所 |
|
17 |
高密度陶瓷封装外壳散热问题探讨 |
拟邀请陶瓷封装/材料厂商/高校研究所 |
|
18 |
光通信技术的发展及陶瓷封装外壳的应用趋势 |
拟邀请光通信企业/封装厂商/高校研究所 |
以最终议题为准。更多议题征集中,欢迎自拟或者推荐议题。演讲&赞助&会议报名请联系李小姐:18124643204(同微信)
赞助及支持企业:

方式一:加微信
李小姐:18124643204(同微信)
邮箱:lirongrong@aibang.com
扫码添加微信,咨询展会详情


原文始发于微信公众号(艾邦陶瓷展):DPC 陶瓷管壳可以替代 HTCC/LTCC 吗
长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入交流群。