对于气密性封装而言,封盖质量是影响最终封装的可靠性及合格率的关键所在。在微电子集成电路的高可靠气密封装中,盖板密封技术主要包括低温合金焊料熔封、平行缝焊、低温玻璃熔封、储能焊及激光焊等几种形式。其中,平行缝焊是一种升温小、气密性高的高可靠性封盖方式,普遍用于对水汽含量和气密性要求标准较高的陶瓷封装和金属管壳封装中。艾邦建有陶瓷封装全产业链微信群,欢迎陶瓷封装产业链上下游扫码加群与我们交流。长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊
一、平行缝焊的工作原理
平行缝焊属于电阻熔焊,在焊接时电极在移动的同时转动(通过电极滚轮),在一定的压力下电极之间断续通电,进行点焊,通过流经一组平行的铜合金滚轮电极的焊接电流在电极与盖板、盖板与焊环之间这两个高阻处产生焦耳热,当温度超过表面镀层熔点时,镀层熔化并形成合金后将盖板与焊环密封。从它的焊接轨迹看像一条缝,所以也称为“缝焊”。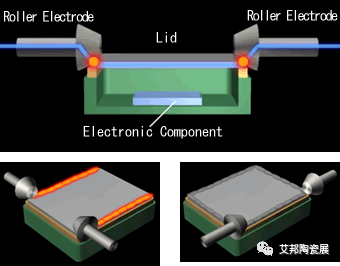
此过程中,除了焊环、盖板表面镀层的熔化外,或多或少还存在部分盖板基体材料的熔化。由于整个封帽过程中仅在焊环处发生焊接行为,外壳整体温度并没有像其他两种盖板熔封工艺一样同步升高。通过适当的工艺参数优化,缝焊过程中外壳的温度可以很容易控制在100℃以下。因此平行缝焊通常被认为是一种局部高温、整体低温的封帽技术。
缝焊最重要的是断续的缝焊轨迹之间没有间隔。平行缝焊的焊缝是由几十甚至上百个连续的焊点组合而成,为保证焊缝的密封性,焊点必须相互重叠,重叠部分控制在30%~50%通常可以保证焊缝的连续,如图所示。当重叠过少,焊缝中出现断点而导致漏气;重叠过多,焊缝本身没有问题但总的焊点数会增多,而每一个焊点的形成都是个高温过程,倘若焊接时间不变,高温过程越多引入的热应力越大,对外壳的热冲击也越大,出现焊环、瓷体间结合处开裂甚至瓷体炸裂的可能性自然也会增大。重叠过多还会增加基体金属的暴露机会,过多的基体材料的暴露会加深盐雾试验中的腐蚀,严重者甚至还会出现焊缝锈蚀穿孔,并直接导致后续密封试验中的失效。因此焊缝质量的优劣对平行缝焊产品的密封质量、可靠性影响较大。二、影响平行缝焊的因素
与合金焊料熔封、低温玻璃熔封两种封帽工艺不同,平行缝焊所形成的焊缝宽度通常只有0.2~0.4 mm,比前两种封帽方式形成的焊缝窄很多。因为焊缝较窄小,缝焊过程一个很小的异常将可能导致气密性不良或其他不良现象发生。为防止电极轮在管壳上滚动时产生的摩擦力带动管壳移动,这样就对家居设计提出更高要求;盖板待封装区域边缘厚度要薄,表面平整、较高光洁度,拐角半径控制在1.4-1.5mm范围,使其R同电极锥度达到良好配合,耐腐蚀性良好。盖板与管座的匹配对气密性有着直接影响,盖板封边缘的厚度、倒角成都、大小等,以及热膨胀系数相匹配;目前用量最大的氧化铝陶瓷底座,与陶瓷热膨胀系数相匹配的的金属焊环是可伐合金或4J42铁镍合金,盖板可采用可伐合金。电极表面的平整度、洁净度以及电极的位置变化对于缝焊的最终可靠性有着直接影响;关键的工艺参数主要包括焊接功率 (焊接电流)、脉冲宽度、脉冲占空比、电极滚动速度及电极压力等。平行缝焊过程中,焊缝位置附近的实际温度通常都超过1000℃,甚至高达1600~1 700℃,因此,实际形成缝焊的过程中,在焊环与陶瓷结合部位通常会出现一个较大的温度梯度并产生一定程度的热应力,倘若工艺控制不当的话,引入的热应力会导致焊环与陶瓷之间的开裂。此外,焊接参数设置不当也会直接带来漏气问题。三、平行缝焊的应用领域
平行缝焊过程主要是在盖板局部产生温升,被广泛用于混合电路、微电子单片集成电路以及对温度较敏感器件的气密封装,如晶体器件、光学器件、传感器、MEMS等产品的线性、线性阵列或旋转体封装。资料来源:
3.《影响平行缝焊效果的各工艺参数的分析》,郭建波、孙寅虎、苏新越;5.《浅谈电极对平行缝焊质量的影响》,姚秀华、刘笛;The 7th Ceramic Packages Industry Forum更多议题征集中,演讲&赞助请联系王小姐:13714496434(同微信)
方式一:加微信
王小姐:13714496434(同微信)邮箱:wanghuiying@aibang.com注意:每位参会者均需要提供信息
方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名
https://www.aibang360.com/m/100179?ref=196271
点击阅读原文,即可报名!
原文始发于微信公众号(艾邦陶瓷展):平行缝焊在集成电路管壳气密性封装中的应用