11月30日,中国电子科技集团公司第五十五研究所将出席并赞助支持第七届陶瓷封装产业论坛,研究员 庞学满将做《微波大功率封装外壳技术发展》主题演讲,欢迎大家与会交流。
庞学满,天津大学材料学博士学位,中国电子科技集团公司第五十五研究所封装事业部副主任,研究员级高工。主要专业方向为封装外壳与基板,先后主持承担并完成了多项国家重大工程配套项目。主持研发的低损耗陶瓷材料以及相应微波外壳系列达到国际领先水平,获得国防科工局以及中国电子科技集团公司多项科学技术奖,申请并获得授权十余项外壳领域发明专利,其中包括获得俄罗斯以及欧洲多个国家授权。

中电国基南方集团有限公司封装事业部主要从事微波毫米波及各类半导体器(组)件、集成电路等封装所需的外壳、基板及相关产品的技术研究、产品开发与生产经营工作。“十五”以来事业部承担了国家下达的预研、新品、型谱、支撑、863、973、产业化、可靠性增长、核高基等课题70余项。“十五”以来共获省部级以上科技进步奖32项,获得国家发明专利授权26项。
封装事业部形成了氧化铝、氮化铝高温共烧多层陶瓷、低温共烧多层陶瓷和微晶玻璃四大类材料的产品体系,为客户提供微波毫米波为主的各类封装外壳、多层陶瓷基板、薄膜基板、无源元件等产品以及镀覆、气密封装等工艺服务。事业部建有多条生产线,厂房面积16000平方米,设备先进,工艺稳定,具有良好的批量供应能力。
产品使用频率可以覆盖至60GHz,满足千瓦级功率器件的散热需求,广泛应用于各类微波毫米波器(组)件、集成电路封装、光电产品封装、电力电子产品封装、MEMS 器件封装、金属玻璃封装等。
微波电路封装陶瓷外壳
封装部开发的CQFN封装采用的垂直信号传输结构,可传输DC~40GHz的控制信号或射频信号。常用的引出端节距有1.27mm、0.65mm、0.5mm等,端口数量12~80,外壳与芯片尺寸接近1.2:1。分为金属化接地或金属热沉接地以满足芯片不同的散热需求。封帽形式有平行缝焊、合金熔封等多种。具有尺寸小、重量轻、高频性能优异等特点。
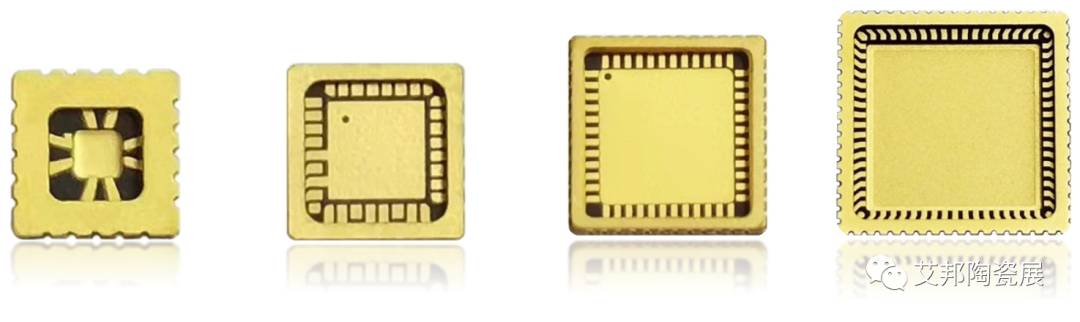
系统封装是当前电子设备小型化、集成化发展的趋势所向,采用基板集成的一体化技术和三维封装结构的SIP(system in package)多芯片组件封装外壳可以满足系统及子系统封装需求,结构紧凑,集成度高。封装形式多样,覆盖BGA、QFN。BGA 型陶瓷外壳主要分为通用BGA型陶瓷外壳与定制BGA陶瓷外壳,其中通用型BGA外壳提供射频与直流传输端口,用户可将多层复杂布线放置于 PCB 中,单层或多层堆叠。定制类BGA陶瓷外壳可根据用户需求进行多层布线,以实现多芯片组件的封装。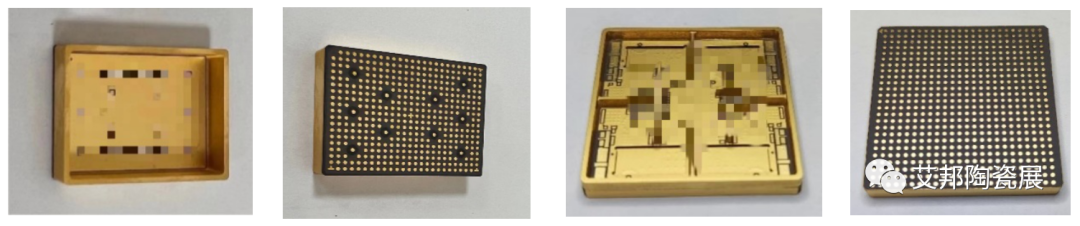
功率电子封装外壳通常指以二极管、三极管、整流器为代表的分立器件封装,主要分为TO和SMD两类。现阶段TO陶瓷封装外壳为三面腔体壁为金属,一面腔体壁为陶瓷,金属引针穿过陶瓷片到内部。以TO外壳为例,耐压性能从1200V提升至 3000V DC,满足以SiC为代表的新一代芯片的封装需求。SMD封装是基于SMT技术发展而来的封装形式,可通过自动拾放设备进行自动化装配。在传统SMD封装的基础上,对载流能力和集成化提出了新要求。通过内镶嵌高导电材料实现大载流,同时腔内集成其他无源/有源器件。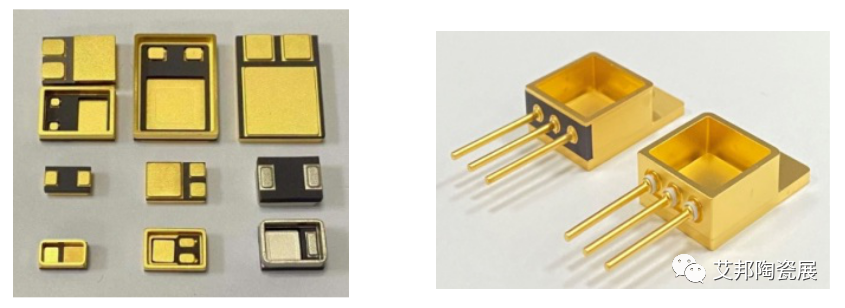
封装部开发的红外探测器封装外壳分为制冷型及非制冷型。其中制冷型红外焦平面探测器用陶瓷引线环其主体采用圆形通腔结构,陶瓷引线环可实现外壳内外的电气连接以及芯片的支撑保护,金属圆环实现与光窗和外部制冷器的焊接。广泛应用于各类高精度高可靠红外成像和制导领域。非制冷型红外探测器陶瓷封装外壳,从结构上可分为蝶形结构的金属外壳以及CLCC(CQFN)和CPGA类型的陶瓷外壳。具有多引出端、高可靠性的特点。最大电流承载能力:5A,气密性:漏率≤1.0× 10-3pa•cm9/s,绝缘电阻≥1.0× 109Ω。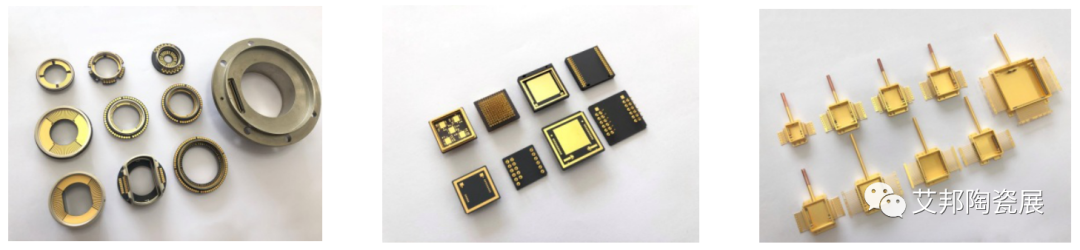
光通讯陶瓷封装外壳应用于光纤通信领域,主要分为蝶形封装外壳及BOX封装外壳,用于封装各类光电发射、接收器件以及大功率激光器。产品参数、气密性、可靠性均满足国际标准要求,产品外形、结构可接受用户的定制化要求。BOX封装多用于多通道并行封装,主要应用于40G以上速率的高速光模块,具有高速率电磁干扰、体积小、散热性好等特性。
封装部开发的集成电路陶瓷外壳广泛应用于FPGA、DSP、CPU、SOC等大规模和超大规模集成电路封装,是目前应用范围最广的封装外壳,产品系列包括CSOP、CQFP、CFP、CLCC、CDIP、CPGA等封装形式,可根据用户的要求定制开发各种集成电路外壳。端口数量:3~256。典型节距:2.54、1.27mm、1.0mm、0.80mm、0.635mm、0.50mm等 ,月产能30万只。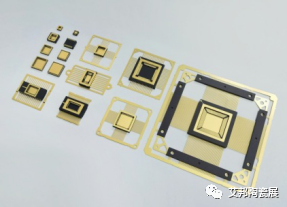
封装部开发以钛合金为基材制备的吸氢材料,能够有效吸附并贮存器件及组件密闭腔体内所不停释放的氢气,避免了封装体内氢气对器件或组件的电性能和物理性能上的损坏,防止“氢中毒”事件的发生,可广泛用于各类有控氢要求的器件和组件。吸氢材料的特点为吸氢量大,最大吸氢量可达 1.8%wt,同时可定制不同形状(片式、围框、螺钉等),无粉末,使用温度宽,耐高温,使用简便,无需前处理。其适用于各类封装材料的器件组件,如可伐、钨铜、硅铝、铝合金等;密度为4.5g/cm3,可满足各类器件或组件。吸氢材料经85℃~250℃烘烤48h激发后,内部氢含量≤500ppm。货架尺寸:3×3×0.3、4×4×0.3、2×5×0.3、3.5×5×0.3,使用方式为导电胶粘接(通用)、锡银铜/铅锡/金锡等焊接。

点击阅读原文,即可在线报名!
原文始发于微信公众号(艾邦陶瓷展):中电科55所将参加第七届陶瓷封装产业论坛并做《微波大功率封装外壳技术发展》主题演讲