导语
11月30日,佛山市佛大华康科技有限公司将出席并赞助支持第七届陶瓷封装产业论坛,总经理 刘荣富将做《芯片管壳等温空腔封装》主题演讲,欢迎大家与会交流。

1、芯片管壳上盖等温封装设备特点
2、芯片管壳上盖等温封装工艺特性
2005年5月至今,任佛山市佛大华康科技有限公司总经理、高级工程师,负责智能装备及其生产工艺定制化整体解决方案研发及实施,主导开发自主知识产权半导体管壳上盖等温封装设备与B-Stage带胶盖板封装工艺结合,通过ASK-Designer4.0系统,实现智能工艺管壳空腔封装。
管壳空腔封装系统解决方案通过射频、电源管理芯片等业内头部企业的可靠性验证和批量化生产,有效管控封装过程可能产生的溢胶、炸胶、偏位、翘起、漏气等现象,实现批量封盖,封装产品一致性、统一性更高,品质更优。
获相关专利、软著等科技成果56项,荣获佛山市科技杰出青年称号,获得3项科技奖项。

专业解决方案
等温封装设备:半自动等温工艺密封设备、全自动等温工艺密封设备
- 智能批量精密封装,提高工作效率和封装精度。
- AI智能精密温度控制,确保稳定的封装温度。
- 智能闭环柔性力控,保障封装过程中的柔性力合理可控。

(佛大华康科技等温封装设备)
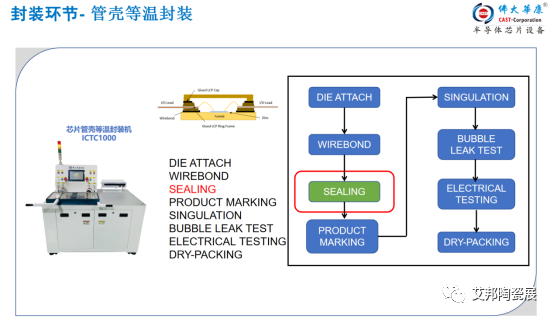
(佛大华康等温封装设备工艺环节)
ACP空腔封装方案


- 解决工艺痛点,通过专利技术优化溢胶、炸胶、偏位、漏气等问题。

(行业部份痛点)
材料供应
- 与生态圈合作伙伴一起提供带胶陶瓷盖、树脂盖、金属盖等封装材料,满足不同客户需求。

B-级胶
显著的性能优势
确保芯片在封装过程中的稳定性,提高产品一致性和极高的成品率。

智能化
- 智能批量精密封装,提高工作效率。
- AI智能精密温度控制,确保封装质量。
- 智能闭环柔性力控,保障封装过程的柔性力可控。
先进技术
- 优良可控封装气氛,防止氧化、污染等问题。
- 历史追溯大数据技术,实时记录和追溯封装过程中的各种参数。

专利技术和软件控制技术
提高一致性和合格率:独有的软件控制技术,提高封装芯片的一致性和成品率



佛大华康科技一直致力于提供卓越的产品和服务,与生态圈合作伙伴一道,实现客户的最大满意。我们是中国第一家成功量产空腔封装设备和解决方案的厂家,方案在中国业内头部企业大规模化量产,性能和科技水平遥遥领先。选择佛大华康科技,选择专业、科学、高质量、高可靠性、高一致性、高合格率的封装解决方案。

原文始发于微信公众号(艾邦陶瓷展):佛大华康将参加第七届陶瓷封装产业论坛并做《芯片管壳等温空腔封装》主题演讲和展台展示
