碳化硅衬底有诸多缺陷无法直接加工,需要在其上经过外延工艺生长出特定单晶薄膜才能制作芯片晶圆,这层薄膜便是外延层。几乎所有的碳化硅器件均在外延材料上实现,高质量的碳化硅同质外延材料是碳化硅器件研制的基础,外延材料的性能直接决定了碳化硅器件性能的实现。
大电流、高可靠性的碳化硅器件对外延材料的表面形貌、缺陷密度以及掺杂和厚度均匀性等方面提出了更苛刻的要求,大尺寸、低缺陷密度和高均匀性的碳化硅外延已成为碳化硅产业发展的关键。
制备高质量的碳化硅外延,要依靠先进的工艺和设备,目前应用最广泛的碳化硅外延生长方法是化学气相沉积(Chemical vapor deposition,CVD),其拥有精确控制外延膜厚度和掺杂浓度、缺陷较少、生长速度适中、过程自动控制等优点,是已经成功商业化应用的可靠技术。
碳化硅CVD外延一般采用热壁或温壁式CVD设备,在较高的生长温度条件(1500~1700℃)下保证了外延层4H晶型SiC的延续,热壁或温壁式CVD经过多年的发展,按照进气气流方向与衬底表面的关系,反应室可以分为水平卧式结构反应炉和垂直立式结构反应炉。
碳化硅外延炉的好坏主要有三个方面的指标,首先是外延生长性能,包括厚度均匀性、掺杂均匀性、缺陷率和生长速率;其次是设备本身温度性能,包括升温/降温速率、最高温度、温度均匀性;最后是设备本身的性价比,包括单台价格和产能。
三种碳化硅外延生长炉的差异
热壁水平卧式CVD、温壁行星式CVD以及准热壁立式CVD是现阶段已实现商业应用的主流外延设备技术方案,三种技术设备也有各自的特点,可以根据需求进行选择,其结构示意如下图所示:
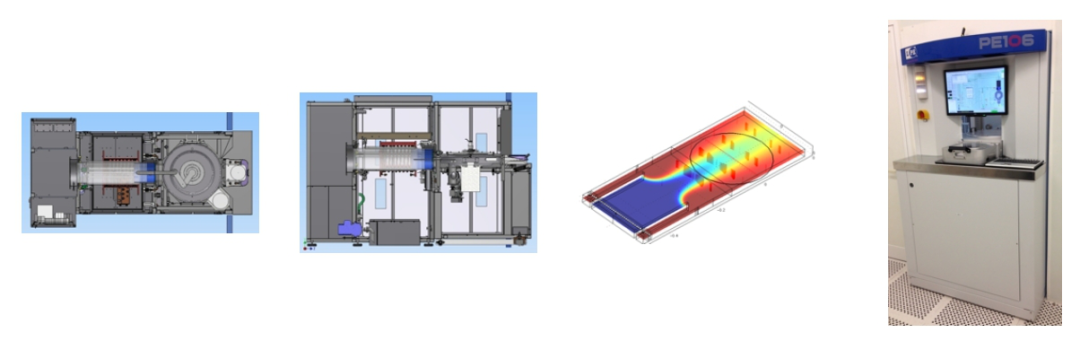
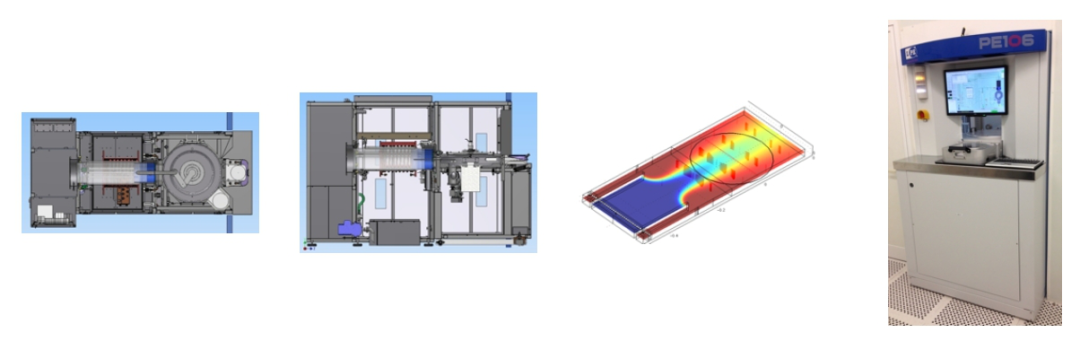
根据LPE官方报道,结合主要用户的使用情况,Pe1O6外延炉生产的厚度30μm以下100-150mm(4-6英寸)4H-SiC外延片产品可以稳定达到如下指标:片内外延厚度不均匀性≤2%,片内掺杂浓度不均匀性≤5%,表面缺陷密度≤1cm-2,表面无缺陷面积(2mm×2mm单元格)≥90%。
国内有晶盛机电、中国电科48所、北方华创、纳设智能等企业开发了具有类似功能的单片式碳化硅外延设备,并已实现了规模出货。如2023年2月,晶盛机电发布的6英寸双片式SiC外延设备,该设备通过对反应室石墨件的改造,采用上下层叠加的方式,单炉可以生长两片外延片,且上下层工艺气体可以单独调控,温差≤5℃,有效弥补了单片水平式外延炉产能不足的劣势。
温壁行星式CVD系统,以行星排布基座的方式,特点是单炉多片生长,产出效率较高。代表性机型为德国Aixtron公司的AIXG5WWC(8X150mm)和G10-SiC(9×150mm或6×200mm)系列外延设备。
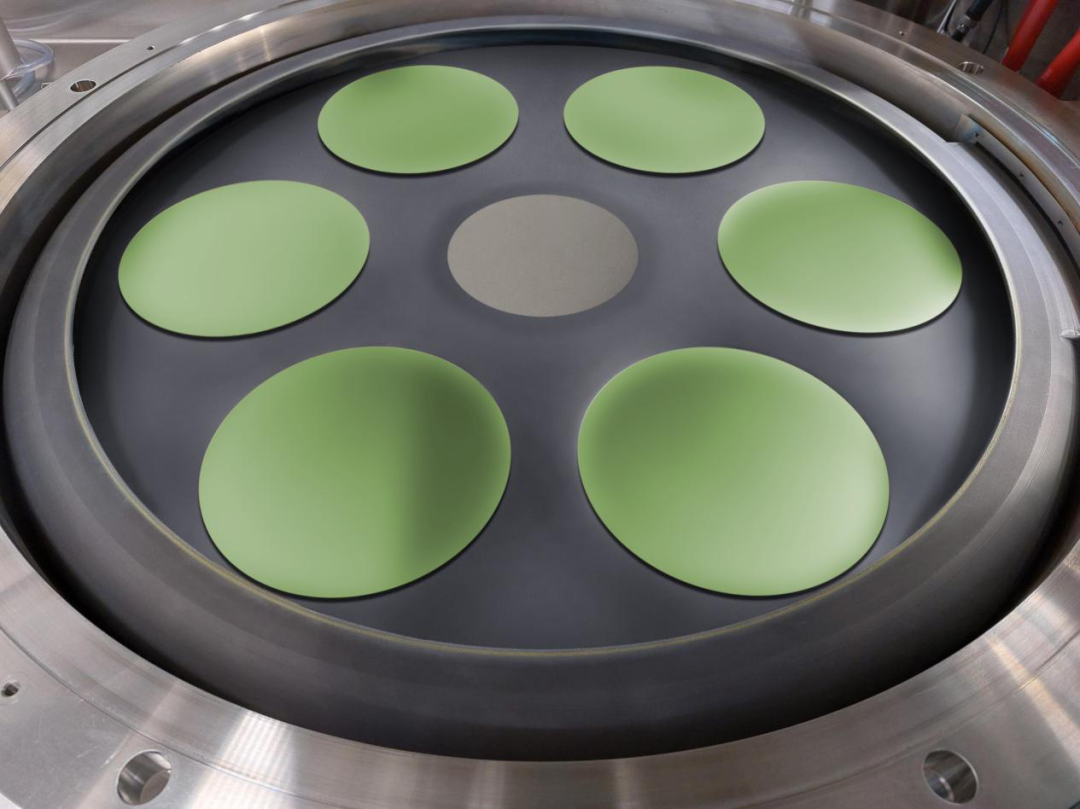
据Aixtron官方报道,G10外延炉生产的厚度10μm的6英寸4H-SiC外延片产品可以稳定达到如下指标:片间外延厚度偏差土2.5%,片内外延厚度不均匀性2%,片间掺杂浓度偏差土5%,片内掺杂浓度不均匀性<2%。
截至目前,此类机型在国内用户端使用较少,批量生产数据不足,在一定程度上制约了其工程化应用,并且由于多片式外延炉在温场和流场控制等方面技术壁垒较高,国内同类设备开发仍处于研发阶段,尚无替代机型。
准热壁立式CVD系统,主要通过外部机械辅助基座高速旋转,特点是通过较低的反应室压力有效降低粘滞层厚度从而提高了外延生长速率,同时其反应室没有能够沉积SiC颗粒的上壁,不易产生掉落物,在缺陷控制上拥有先天优势,代表性机型为日本Nuflare公司的单片式外延炉EPIREVOS6、EPIREVOS8。
据Nuflare报道,EPIREVOS6设备的生长速率可以达到50μm/h以上,且外延片表面缺陷密度可控制在0.1cm-²以下;在均匀性控制方面,Nuflare工程师YoshiakiDaigo报道了采用EPIREVOS6生长的10μm厚6英寸外延片的片内均匀性结果,片内厚度和掺杂浓度不均匀性分别达到1%和2.6%。
目前,芯三代、晶盛机电等国内设备制造商已经设计并推出了具有类似功能的外延设备,但还没有大规模的使用。
综合来看,3种结构形式的设备各具自身特点,在不同的应用需求占据着一定的市场份额:
热壁水平卧式CVD结构特点是具有超快生长速率、质量与均匀性得到兼顾,设备操作维护简单,大生产应用成熟,不过由于单片式及经常需要维护,生产效率较低;温壁行星式CVD一般采用6(片)×100 mm(4英寸)或8(片)×150 mm(6英寸)托盘结构形式,在产能方面大大提升了设备的生产效率,但多片一致性控制存在困难,生产良率仍是面临的最大难题;准热壁立式CVD结构复杂,生产外延片质量缺陷控制极佳,需要极其丰富的设备维护和使用经验。

随着产业不断发展,这3种设备进行结构形式上的迭代优化升级,设备配置将越来越完善,在匹配不同厚度、缺陷要求的外延片规格发挥重要的作用。
参考资料:
1、化学气相沉积法碳化硅外延设备技术进展
2、基于国产单晶衬底的150mm4H-SiC同质外延技术进展
-end-
原文始发于微信公众号(艾邦半导体网):碳化硅外延生长炉的不同技术路线

