低温共烧陶瓷技术是一种以微晶玻璃或玻璃/陶瓷两相复合材料为基础的新型微电子封装技术。LTCC 技术以其优异的电学、热学、机械及互联特性,已成为新一代无源器件小型化、集成化、多功能化及系统级封装的首选方式,被广泛应用于各种微电子器件领域,如高精度片式元件、无源集成功能器件、无源集成基板及微电子功能模块等封装制品中。近年来,5G/6G移动通信、虚拟现实、人工智能等新兴技术的涌现为 LTCC 材料的发展带来了全新的机遇。
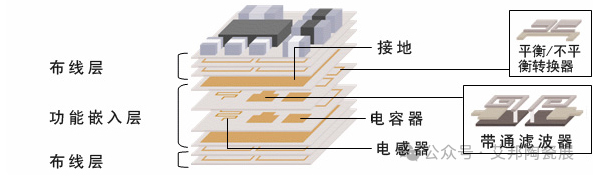
系统级集成封装向高密度、多功能、大功率和智能化方向发展已成为不可避免的趋势,而随集成度的持续增加,热耗散功率密度急剧上升,导致微电子器件的散热问题愈发突出,严重威胁微电子器件的可靠性和使用寿命,这便对 LTCC 基板材料的散热性能提出了非常严苛的要求。一般地,固体材料的热导率与其声子平均自由程密切相关。而玻璃材料原子排列具有短程有序、长程无序的特点,导致玻璃基体声子平均自由程较小,这使得以微晶玻璃或玻璃/陶瓷两相复相材料为基础的 LTCC 材料的热导率较低,难以满足大规模及超大规模集成电路的应用要求。
1、LTCC 技术的特点
LTCC 技术主要是采用可低温烧结的玻璃或玻璃陶瓷复合材料,通过流延成型制出厚度精确且致密的生瓷带,再通过激光打孔、精密丝网印刷等工艺在生瓷带上印刷电路图形,将多层生瓷带叠压,并在生瓷带中内埋必要的元件,利用 Au、Ag 等金属浆料制成内外电极,最后在低于900℃下烧结,形成高密度的电路基板。
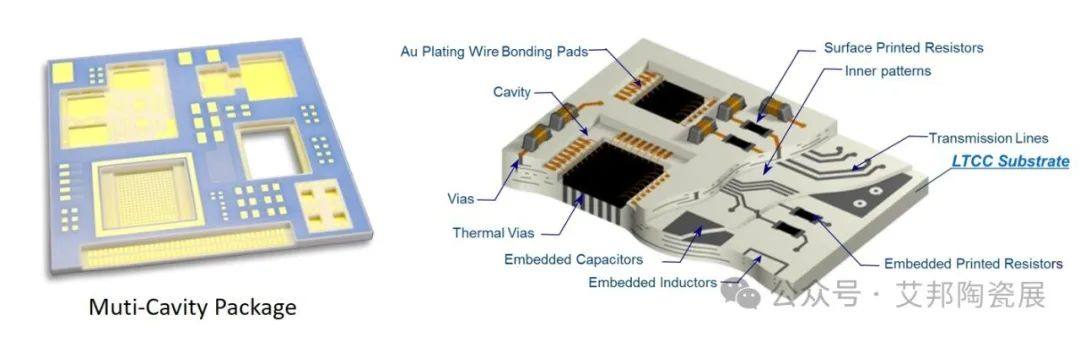
LTCC 技术是一种先进的无源集成及混合电路封装技术,与其他集成电路封装技术相比显示出巨大的优越性,能够显著提高多层微电路芯片封装设计的灵活性。LTCC 技术的特点:
(1)介电性能的可调控性。LTCC 材料在拥有较低的介电损耗的同时可以通过调节原料成分及其配比调控介电常数,适配于不同需求的基板,提高电路设计的活性。
(2)较低的烧结温度。LTCC 技术可以在低温条件下进行烧结,降低能耗,从而避免高温对电子元件和材料的损害。
(3)高密度导线布线能力。LTCC 工艺优化了线宽间距使其更小,可以实现更加紧密的布线结构,提供更高的导电率和更好的信号传输性能。
(4)可以实现无源件的集成。通过内埋的方式减少电感、滤波器等元件数量,以此提升封装密度与可靠性。
(5)具有良好的工艺兼容性。能够与多种材料组合,并与层布线技术相互兼容,得到高性能的混合多芯片组件,实现更加高效和灵活的设计和生产。
2、LTCC 材料热导率的影响因素
LTCC 材料导热载体主要是声子,热导率的大小由声子的平均自由程决定,其导热性能与它的成分组成和杂质含量、缺陷及孔隙率、颗粒尺寸和结构密度、热处理程序等因素有关。为了提升材料的热导率往往会采用提升材料纯度与密度、减少气孔及缺陷的产生、合理的热处理程序及在晶体内部构建导热通道等方式来提升材料性能。
原料成分和配比的不同影响着 LTCC 材料的热导率尽管LTCC材料具有比普通PCB基板更好的导热性,但由于其玻璃相较多,其热导率仅为 2.0~2.5W/(m·K) 为了满足更加高效、节能的需求,提升 LTCC 材料热导率,采用的最普遍的方式是组分掺杂。一些材料在制备过程中会出现晶粒生长异常等状况,填料的加入能有效改变析晶速度、延缓离子迁移速率、提高热导率。同时,某些特殊物料的加入还可以在材料内部构筑高导热网络,提升材料导热性能。

在制备 LTCC 材料时需要通过烧结来提升性能,在此过程中由于胚体中含有杂质和较多的玻璃相,其内部会产生气孔。孔径的大小直接影响材料内部热能的传输效率,孔径越大,热能传输得越快;气孔分布的均匀性影响材料内部的热能传输的均匀性;气孔间相互连通的方式直接决定了材料内部热能的传输通道。
材料的内部缺陷和显微结构会影响声子的传播使热导率发生改变。缺陷会产生引起声子散射的中心,降低声子的平均自由程和导热系数。因此,在制备 LTCC 材料时可以采取增加烧结时间和添加烧结助剂等方式来减少缺陷的产生。LTCC 材料的导热性很大程度上取决于所加入的物料,但在烧结过程中这些物料会与原物质发生物理化学反应,使其内部结构改变,产生缺陷。因此,在选取原料时应注意所添加物料对 LTCC 材料的结构变化影响。
制备 LTCC 材料的流程中,热处理是最重要的一步。在此过程中会发生一系列的物理化学变化,影响材料的显微结构。热处理的烧结温度、升温速率、保温时间都对材料的内部结构有一定影响,这也导致在不同条件下热处理过的材料热导率有所不同。LTCC 材料的性能主要受所析出晶相种类、结晶度及晶粒尺寸等因素影响,合理的热处理温度和时间能够有效促进玻璃的析晶,增加结晶度,使晶粒尺寸变大,进而提升热导率。
来源:《高导热低温共烧陶瓷(LTCC)材料的研究进展》,肖楠,等.
艾邦建有LTCC交流群,诚邀LTCC生产企业、设备、材料企业参与。

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入LTCC交流群。
The 2nd Ceramic Packages Industry Forum
河北·石家庄
|
序号
|
暂定议题
|
拟邀请
|
|
1
|
集成电路陶瓷封装的发展概况
|
拟邀请陶瓷封装厂商/高校研究所
|
|
2
|
光通信技术的发展及陶瓷封装外壳的应用趋势
|
拟邀请光通信企业/封装厂商/高校研究所
|
|
3
|
电子封装陶瓷的研究进展
|
拟邀请陶瓷封装厂商/高校研究所
|
|
4
|
陶瓷封装技术在传感器领域的应用
|
拟邀请陶瓷封装厂商/高校研究所
|
|
5
|
基于DPC的3D成型陶瓷封装技术
|
拟邀请陶瓷封装厂商/高校研究所
|
|
6
|
集成电路陶瓷封装外壳仿真设计
|
拟邀请陶瓷封装厂商/高校研究所
|
|
7
|
系统级封装用陶瓷材料研究进展和发展趋势
|
拟邀请陶瓷封装厂商/高校研究所
|
|
8
|
基于3D-SiP集成技术的新型微波模块
|
拟邀请陶瓷封装厂商/高校研究所
|
|
9
|
陶瓷封装结构优化及可靠性分析
|
拟邀请陶瓷封装厂商/高校研究所
|
|
10
|
低温玻璃-陶瓷封装技术的研究进展
|
拟邀请陶瓷封装厂商/高校研究所
|
|
11
|
低温共烧陶瓷基板及其封装应用
|
拟邀请陶瓷封装厂商/高校研究所
|
|
12
|
微电子陶瓷封装的金属化技术
|
拟邀请陶瓷封装厂商/高校研究所
|
|
13
|
高温共烧陶瓷金属化膜厚影响因素分析
|
拟邀请陶瓷封装厂商/高校研究所
|
|
14
|
铜浆在多层陶瓷封装外壳制备技术中的应用
|
拟邀请陶瓷封装/浆料厂商/高校研究所
|
|
15
|
电子陶瓷封装用玻璃粉的开发
|
拟邀请陶瓷封装/玻璃粉厂商/高校研究所
|
|
16
|
金属陶瓷胶黏剂封装工艺及可靠性研究
|
拟邀请陶瓷封装/材料厂商/高校研究所
|
|
17
|
陶瓷封装外壳钎焊工艺研究
|
拟邀请钎焊设备企业/高校研究所
|
|
18
|
高密度陶瓷封装外壳散热问题探讨
|
拟邀请陶瓷封装/材料厂商/高校研究所
|
|
19
|
陶瓷封装平行缝焊工艺与技术
|
拟邀请陶瓷封装/设备厂商/高校研究所
|
|
20
|
陶瓷封装缺陷自动检测技术
|
拟邀请检测方案商
|
更多议题征集中,欢迎自拟或者推荐议题。演讲&赞助&会议报名请联系李小姐:18124643204(同微信)
方式一:加微信
李小姐:18124643204(同微信)
邮箱:lirongrong@aibang.com
扫码添加微信,咨询展会详情


https://www.aibang360.com/m/100216?ref=196271
点击阅读原文,即可在线报名!
原文始发于微信公众号(艾邦陶瓷展):影响低温共烧陶瓷(LTCC)材料热导率的关键因素分析