
长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊
1、SIP的基板材料要求
(1)低的介电常数、信号传输速度与基板材料的介电常数和信号传输距离有关,介电常数越低,信号传输越快。
(2)低介电损耗。在基板材料的电导和松弛极化过程中,带电质点将电磁场能部分地转化为热能,将能量消耗在使封装材料发热的效应上,介电损耗低能够大大降低基板的发热效应。
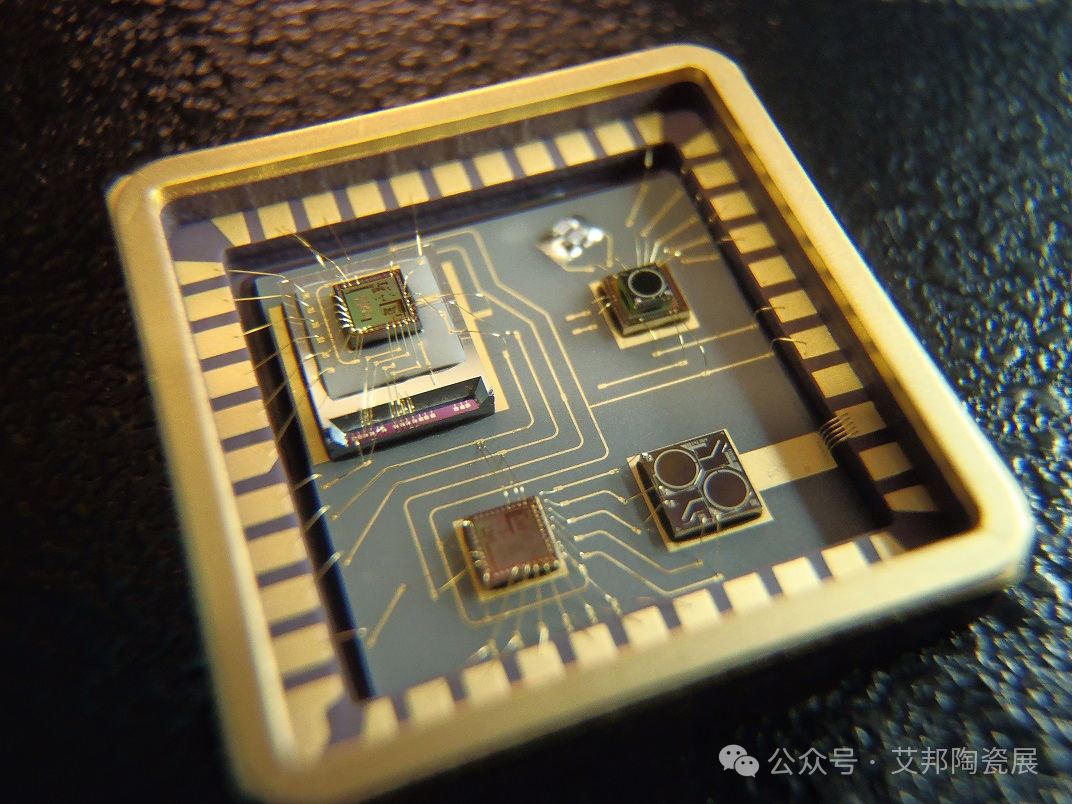
图 系统级封装,来源:ALTER
(3)高热导率。芯片电路密度增加、功率提高信号速度加快、芯片发热量增加,基板材料热导率越高,能够有效散发芯片发出热量。
(4)适宜的热膨胀系数。电路工作时,由于热膨胀系数不同会产生应力,使焊点疲劳、失效,严重时导致膜层剥落,甚至破坏芯片,因此,基板材料要与芯片的热膨胀系数匹配。
(5)良好的力学性能。基板材料需要具有良好的弯曲强度和弹性模量,一方面保证基板烧结过程中变形量小,减少尺寸差别;另一方面,保证基板在制备、装配、使用过程中不至于破损。
二、SIP用陶瓷基板材料

1.AIN
SIP芯片堆叠后发热量将增加,但散热面积相对并未增加,因而发热密度大幅提高,而且由于热源的相互连接,热耦合增强,从而造成更为严重的热问题。同时,内埋置基板中的无源器件也有一定的发热问题。因此,SIP在封装体积缩小、组装密度增加的同时必然带来散热的问题,选择散热效果更好即热导率更高的陶瓷材料是实现SIP的关键。
AIN是一种具有纤锌矿结构的化合物,利用AIN陶瓷制成的多层陶瓷基板的热导率可达170W/(m·K),热膨胀系数仅为4.2x10-6°C-1,与Si、GaAs及GaN器件接近,其力学强度高,致密性好,能够满足封装气密性要求,且介电常数低,适用于高功率、多引线和大尺寸芯片,是SiP封装优选的基板材料和封装材料。
2.低温共烧陶瓷材料
LTCC(Low Temperature Co-fired Ceramic,低温共烧陶瓷)采用厚膜材料,根据预先设计的结构,将电极材料、基板、电子器件等一次烧成,是实现SIP的重要途径。LTCC工艺采用多层陶瓷叠压烧结,高频介质损耗小,高温稳定性好,膨胀系数与集成电路接近易匹配,容易与芯片集成,适合高低频混合和数模一体化封装。同时,LTCC工艺又是一种三维无源基板,可以满足系统高密度布线和紧凑复杂的无源电路要求,能充分发挥大规模集成电路的性能优势。采用LTCC技术的SIP具备高集成度,方便集成无源元件无源功能器件,通过调整配料和多种不同介电常数基板混合共烧的方式提高电路设计灵活性等。
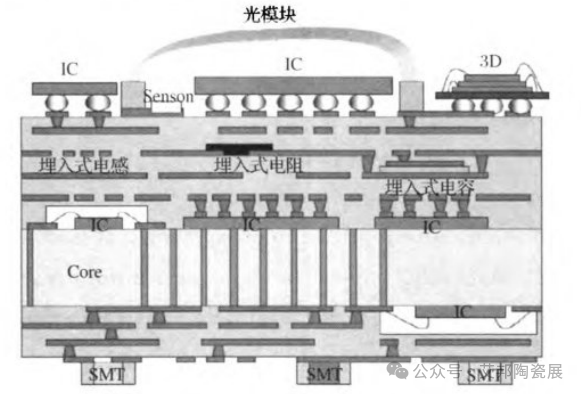
图 系统级封装横截面示意图
⑤基于LTCC技术的SIP同半导体器件有良好的热匹配性能。LTCC的热膨胀系数与Si、GaAs、InP接近,可以直接在基板上进行芯片的组装。
随着封装密度不断提高、功能日趋多样化,单一材料的性能已不能满足需求。未来电子封装材料将会朝着多相复合化的方向持续发展。
1.《系统级封装用陶瓷基板材料研究进展和发展趋势》,高岭,赵东亮.

河北·石家庄
序号 | 暂定议题 | 拟邀请 |
1 | 集成电路陶瓷封装的发展概况 | 拟邀请陶瓷封装厂商/高校研究所 |
2 | 光通信技术的发展及陶瓷封装外壳的应用趋势 | 拟邀请光通信企业/封装厂商/高校研究所 |
3 | 电子封装陶瓷的研究进展 | 拟邀请陶瓷封装厂商/高校研究所 |
4 | 陶瓷封装技术在传感器领域的应用 | 拟邀请陶瓷封装厂商/高校研究所 |
5 | 基于DPC的3D成型陶瓷封装技术 | 拟邀请陶瓷封装厂商/高校研究所 |
6 | 集成电路陶瓷封装外壳仿真设计 | 拟邀请陶瓷封装厂商/高校研究所 |
7 | 系统级封装用陶瓷材料研究进展和发展趋势 | 拟邀请陶瓷封装厂商/高校研究所 |
8 | 基于3D-SiP集成技术的新型微波模块 | 拟邀请陶瓷封装厂商/高校研究所 |
9 | 陶瓷封装结构优化及可靠性分析 | 拟邀请陶瓷封装厂商/高校研究所 |
10 | 低温玻璃-陶瓷封装技术的研究进展 | 拟邀请陶瓷封装厂商/高校研究所 |
11 | 低温共烧陶瓷基板及其封装应用 | 拟邀请陶瓷封装厂商/高校研究所 |
12 | 微电子陶瓷封装的金属化技术 | 拟邀请陶瓷封装厂商/高校研究所 |
13 | 高温共烧陶瓷金属化膜厚影响因素分析 | 拟邀请陶瓷封装厂商/高校研究所 |
14 | 铜浆在多层陶瓷封装外壳制备技术中的应用 | 拟邀请陶瓷封装/浆料厂商/高校研究所 |
15 | 电子陶瓷封装用玻璃粉的开发 | 拟邀请陶瓷封装/玻璃粉厂商/高校研究所 |
16 | 金属陶瓷胶黏剂封装工艺及可靠性研究 | 拟邀请陶瓷封装/材料厂商/高校研究所 |
17 | 陶瓷封装外壳钎焊工艺研究 | 拟邀请钎焊设备企业/高校研究所 |
18 | 高密度陶瓷封装外壳散热问题探讨 | 拟邀请陶瓷封装/材料厂商/高校研究所 |
19 | 陶瓷封装平行缝焊工艺与技术 | 拟邀请陶瓷封装/设备厂商/高校研究所 |
20 | 陶瓷封装缺陷自动检测技术 | 拟邀请检测方案商 |
方式一:加微信
李小姐:18124643204(同微信)
邮箱:lirongrong@aibang.com
扫码添加微信,咨询展会详情


点击阅读原文,即可在线报名!
原文始发于微信公众号(艾邦陶瓷展):一文了解系统级封装SIP用陶瓷基板材料
长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入交流群。

