陶瓷外壳封装工艺流程主要包括硅片减薄、划片、装片、键合、封帽、植球(针对CBGA)、回流焊等工序。其中植球和回流焊在 CBGA 封装属于关键工艺。

艾邦建有陶瓷封装全产业链微信群,欢迎陶瓷封装产业链上下游加入,请您识别二维码加入。长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊1.硅片减薄
微电子产品在集成度、速度和可靠性不断提高的同时正向轻薄短小的方向发展,与此相适应,新型的芯片封装技术不断涌现,这些先进的封装技术所需要的芯片厚度越来越薄。为满足片式封装器件薄型化需求,在划片前必须对硅片进行减薄。(1)提高热扩散效率随着半导体结构越来越复杂、集成度越来越高,晶体管体积不断减小,散热已逐渐成为影响芯片性能和寿命的关键因素,薄的芯片更有利于散热。(2)减小芯片封装体积微电子产品日益向轻薄短小的方向发展,减小芯片封装体积是适应这一发展趋势的必由之路。(3)提高机械性能减薄后的芯片机械性能显著提高,硅片越薄,其柔韧性越好,受外力冲击引起的应力也越小。(4)提高电气性能晶片的厚度越薄元件之间的连线将越短,元件导通电阻将越低,信号延迟时间越短,从而实现更高的性能。(5)减轻划片加工量减薄以后再切割,可以减小划片(Dicing)时的加工量,降低芯片崩边的发生率。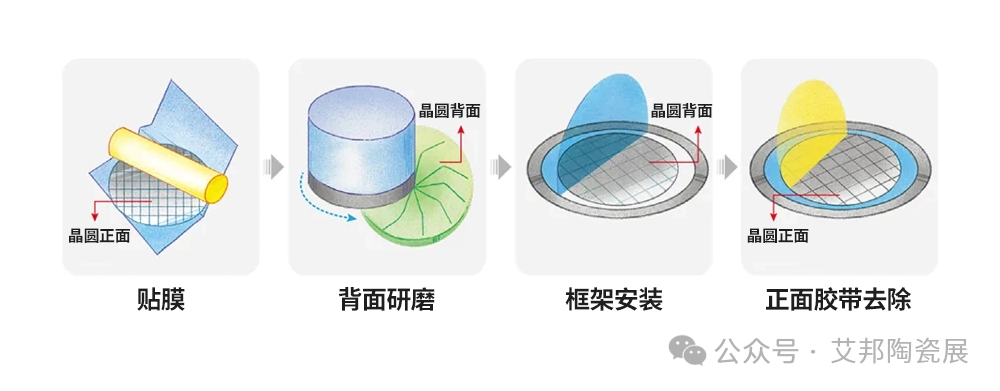
图 晶圆背面研磨工艺的四个步骤,来源:SK Hynix高端芯片封装时需要进行硅片减薄,硅片减薄后可以增加导热效果、柔韧 性好、提高电性能等特点,然而当硅片减薄过程中,硅片易产生翘曲、崩边、碎片等现象,硅片表面质量不受控。再有在倒装芯片封装过程中,芯片应力处理不好,会导致芯片边缘和中央发生裂纹现象,导致器件失效,特别是对大面积芯片更容易发生,所以芯片应力消除十分重要,而芯片应力产生主要来源于芯片减薄过程中。研究认为,芯片在减薄完成后,必须进行抛光处理,抛光深度一般在1~5um范围内,抛光后可以有效克服芯片因减薄带来的应力问题。2.划片工艺
在一个晶圆上,通常有几百个至数千个芯片连在一起。它们之间留有一定的间隙,此间隙被称之为划片街区(Saw Street)。将每一个具有独立电气性能的芯片分离出来的过程叫做划片或切割(Dicing Saw)。常用的方法有金刚刀划片、砂轮划片和激光划片等几种。划片前首先需将晶圆贴在划片膜上,并用专用框架固定,然后放入设备设置好程序进行自动划切。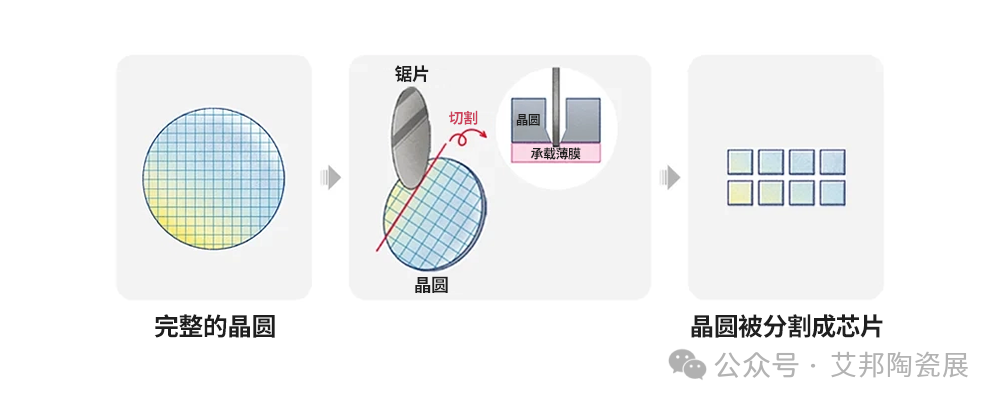
3.装片工艺
装片就是把集成电路芯片按照图纸粘接到外壳衬底(如多层陶瓷封装)或引线框架(如塑料封装)上的指定位置,完成芯片的安装。根据目前各种封装结构和技术要求,装片工艺可分为导电胶粘接法、低温玻璃烧结法和低熔点合金的共晶焊接法等。焊接层除了为器件提供机械连接和电连接外,还须为器件提供良好的散热通道。其方法可分为环氧树脂粘接法和金属合金焊接法。芯片在陶瓷基板上的粘接采用的主要材料有环氧树脂(导电型、绝缘型)、聚酞亚胺等有机粘接剂和Au-Si共晶焊料、Au-Sn共晶焊料、Ag-玻璃焊料和软合金(如Sn-Pb)焊料等无机粘接剂,配制成浆料或膜片的形式。无机材料的粘接原理靠的是元件粘接面之间的金属合金化而形成电气连接或固定,有机材料的粘接原理则是依靠粘接材料的强大粘接力使元件粘接面之间形成物理连接。无机粘接剂的优点在于能引起污染的副产物较少(潮气和腐蚀物少),其缺点是要面临粘接器件的选择。4.键合工艺
集成电路的芯片互连是将芯片pad与电子封装外壳或基板键合指相连接,实现芯片与封装结构的电路连接,发挥已有的功能。芯片互连常见的方法有引线键合(Wire Bonding,WB)、载带自动键合(Tape Automated Bonding,TAB)、倒装芯片键合(Flip Chip,FC)三种工艺。表 WB、TAB、FC三种互连技术比较
● WB主要有合两种方式:楔焊键合和球焊键。楔键合是通过楔形劈刀将热、压力、超声传给金属丝(一般是硅铝丝),设置一定的时间后焊接形成,焊接过程中不出现焊球;楔键合工艺中,劈刀背面有一个通孔,将金属丝穿过通孔,与水平的被键合表面成30°~60°倾斜角度;球键合时将金丝穿过键合机劈刀毛细管,到达其顶部,利用氢氧焰或电气放电系统产生电火花以熔化金属丝在劈刀外的伸出部分,在表面张力作用下熔融金属凝固形成标准的球形,球直径一般是线径的2倍~3倍,紧接着降下劈刀,在适当的压力和定好的时间内将金球压在电极或芯片上。● TAB键合技术是将芯片pad焊区与电子封装外壳或基板上的金属布线焊区用具有引线图形的金属箔丝连接的技术工艺。TAB技术相对于WB技术更容易实现标准化和自动化,从而实现产业规模生产,降低产品成本,提高生产效率。● FC是芯片面朝下,芯片pad与基板焊区直接互连的一种方法。相对于WB和TAB互连技术,由于FC的互连省略互连线,互连产生的杂散电容、互连电容与互连电感均比WB和TAB小很多,从而有利于高频高速电路的应用;FC占用基板面积较小,芯片安装密度显著提高。5.封帽(气密性封装)工艺
封帽工艺也叫密封,主要是针对陶瓷、金属和玻璃等空腔外壳的密封工艺,其主要作用是保证所封闭的空腔中能具有适合标准的气密性,主要针对集成电路制作过程中经过组装(粘片、键合)并且检验合格后的电路进行密封处理。平行缝焊工艺和熔封工艺是常见的两种封帽工艺。- 平行缝焊属于电阻熔焊,在焊接时电极在移动的同时转动(通过电极滚轮),在一定的压力下电极之间断续通电,进行点焊,通过流经一组平行的铜合金滚轮电极的焊接电流在电极与盖板、盖板与焊环之间这两个高阻处产生焦耳热,当温度超过表面镀层熔点时,镀层熔化并形成合金后将盖板与焊环密封。
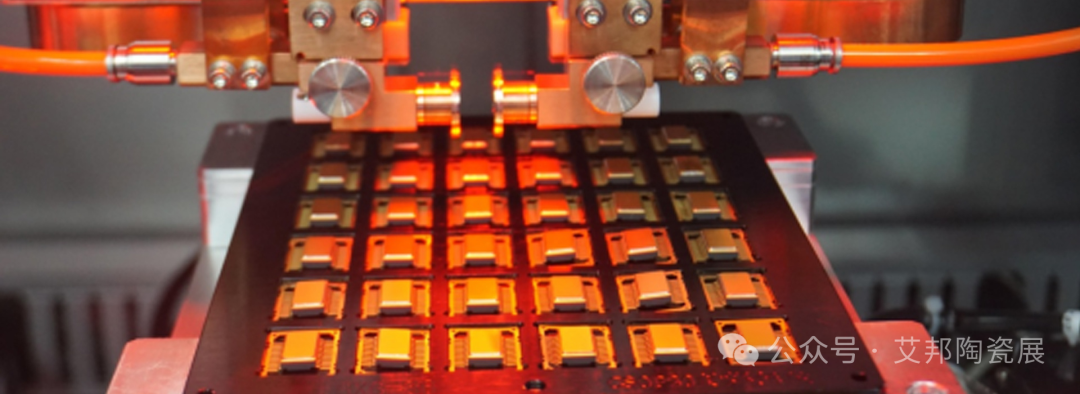
- 熔封工艺工作原理是在盖板上预制一圈焊料环,焊料环主要起到金属活化作用,然后通过专用夹具将键合好的电路与盖板固定,放入烧结炉或链式炉内经过一定的温度曲线,焊料熔化,将盖板、外壳焊接在一起形成良好的密封。
封帽工艺完成后,DIP、FP、QFP、PGA等类产品就完成了封装,而针对于CBGA、CCGA类产品,还需要植球/植柱工艺。6.植球工艺
植球与回流焊工艺是CBGA封装流程中的一部分。植球工艺是CBGA封装中的关键工序,它是利用钎料球实现封装外壳与PCB板之间的互连。CBGA封装的植球工艺一般采用高铅锡球作为互连材料,在一定温度下,通过63Sn37Pb共晶焊膏熔化将封装外壳上的金属焊盘与高铅锡球形成冶金连接。在此过程中,高铅锡球不熔化。①首先,采用具有一定厚度和网孔直径的网版通过印刷的方式将63Sn37Pb焊膏印刷到陶瓷外壳的金属焊盘上;②然后,在已经印刷好的金属焊盘上通过网版准确的放置高铅锡球;③最后,确认锡球放置无问题后,将陶瓷外壳放入回流炉中,在设定好的回流温度曲线下进行回流,一般经过预热、活化、回流和冷却四个阶段,峰值温度通常在210℃~235℃范围内,此时熔化与金属焊盘及高铅锡球均形成可靠的冶金结合。至此,CBGA封装的植球工艺完成。回流焊(reflow soldering)就是通过加热使预置的钎料膏或钎料凸点重新熔化即再次流动,润湿金属焊盘表面形成牢固连接的过程。常用的回流焊热源有红外辐射、热风、热板传导和激光等。资料来源:
1.CBGA(陶瓷球栅阵列)封装关键工艺技术研究,尹学群.
2.高可靠陶瓷球栅阵列封装技术研究,蒙喜鹏.
3.网络公开信息
艾邦建有陶瓷封装全产业链微信群,欢迎陶瓷封装产业链上下游加入,请您识别二维码加入。长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊The 2nd Ceramic Packages Industry Forum河北·石家庄
一、会议议题 序号 | 暂定议题 | 拟邀请 |
1 | 集成电路陶瓷封装的发展概况 | 拟邀请陶瓷封装厂商/高校研究所 |
2 | 光通信技术的发展及陶瓷封装外壳的应用趋势 | 拟邀请光通信企业/封装厂商/高校研究所 |
3 | 电子封装陶瓷的研究进展 | 拟邀请陶瓷封装厂商/高校研究所 |
4 | 陶瓷封装技术在传感器领域的应用 | 拟邀请陶瓷封装厂商/高校研究所 |
5 | 基于DPC的3D成型陶瓷封装技术 | 拟邀请陶瓷封装厂商/高校研究所 |
6 | 集成电路陶瓷封装外壳仿真设计 | 拟邀请陶瓷封装厂商/高校研究所 |
7 | 系统级封装用陶瓷材料研究进展和发展趋势 | 拟邀请陶瓷封装厂商/高校研究所 |
8 | 基于3D-SiP集成技术的新型微波模块 | 拟邀请陶瓷封装厂商/高校研究所 |
9 | 陶瓷封装结构优化及可靠性分析 | 拟邀请陶瓷封装厂商/高校研究所 |
10 | 低温玻璃-陶瓷封装技术的研究进展 | 拟邀请陶瓷封装厂商/高校研究所 |
11 | 低温共烧陶瓷基板及其封装应用 | 拟邀请陶瓷封装厂商/高校研究所 |
12 | 微电子陶瓷封装的金属化技术 | 拟邀请陶瓷封装厂商/高校研究所 |
13 | 高温共烧陶瓷金属化膜厚影响因素分析 | 拟邀请陶瓷封装厂商/高校研究所 |
14 | 铜浆在多层陶瓷封装外壳制备技术中的应用 | 拟邀请陶瓷封装/浆料厂商/高校研究所 |
15 | 电子陶瓷封装用玻璃粉的开发 | 拟邀请陶瓷封装/玻璃粉厂商/高校研究所 |
16 | 金属陶瓷胶黏剂封装工艺及可靠性研究 | 拟邀请陶瓷封装/材料厂商/高校研究所 |
17 | 陶瓷封装外壳钎焊工艺研究 | 拟邀请钎焊设备企业/高校研究所 |
18 | 高密度陶瓷封装外壳散热问题探讨 | 拟邀请陶瓷封装/材料厂商/高校研究所 |
19 | 陶瓷封装平行缝焊工艺与技术 | 拟邀请陶瓷封装/设备厂商/高校研究所 |
20 | 陶瓷封装缺陷自动检测技术 | 拟邀请检测方案商 |
21 | 传感器技术的发展及陶瓷封装的应用趋势 | 拟邀请传感器/封装厂商/高校院所 |
22 | 红外探测器技术的发展及陶瓷封装的应用趋势 | 拟邀请探测器/封装厂商/高校院所 |
更多议题征集中,欢迎自拟或者推荐议题。演讲&赞助&会议报名请联系李小姐:18124643204(同微信)方式一:加微信
李小姐:18124643204(同微信)
邮箱:lirongrong@aibang.com
扫码添加微信,咨询展会详情


https://www.aibang360.com/m/100216?ref=196271点击阅读原文,即可在线报名!
原文始发于微信公众号(艾邦陶瓷展):一文了解陶瓷外壳封装工艺流程