
随着电子装备对小型轻量化、高集成度、高可靠性和低成本的需求,微波电路急需将不同功能的微波多芯片模块叠层而形成垂直互连的三维微波多芯片组件。艾邦建有陶瓷封装全产业链微信群,欢迎陶瓷封装产业链上下游加入,请您识别二维码加入。长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊一、什么是TCV技术
陶瓷穿孔互连技术(TCV,Through Ceramic Via)简称TCV,是一种应用于高密度三维封装的新型互连技术。其利用陶瓷穿孔实现电路与电路之间、电路与附加单元之间线路垂直导通,利用薄膜多层电路实现多层布线,使电路体积在三维方向得到延伸,达到结构密度最大化。TCV技术状态下同等尺寸器件具备更多功能,拥有好的高频性能,为微系统功率电路、无源元件和器件集成以及多功能单元的高密度组合提供了一种解决方案。典型的TCV器件如下图所示。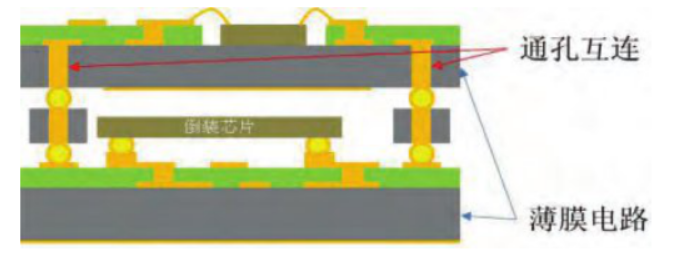
二、TCV技术的应用优势
因传统基板工艺在图形线宽/线距、任意层互连、无源器件集成等方面的限制,无法一体化集成部分高性能单元。当前小型化产品通常的做法是通过后期微组装技术在多层基板上实现平面集成,所有功能单元只能在基板二维方向上平铺安装,嵌入器件的级联设计较为复杂,产品体积较大,成本较高。
TCV技术采用通孔互连和线路重分布,使平面分布的高精度、高功率的薄膜电路体积在三维方向得到延伸,大大提高了结构密度,减少了器件尺寸。通过TCV技术将薄膜多层电路、无源器件、倒装芯片、TSV等封装到独立的IP核中,再装配到多层母板表面,可以有效解决宽带射频垂直传输、高精度器件、无源器件集成等问题,并有效缩小系统体积,为微系统集成提供有力支持。在TCV集成模块中可以将射频单元、功率单元、处理单元等通过平面传输、元件耦合和垂直互联的方式紧密集成一体,整体可进行气密性封装。基于TCV技术的微波组件在共形阵列天线、智能蒙皮、微型导弹、微纳卫星等系统微小型产品中具有广泛的应用前景。三、TCV技术的工艺流程
TCV的集成工艺流程是从经典的薄膜制程中提升和发展而来,其中共性技术如金属化、图形光刻、显影、蚀刻、电镀、集成电阻等是必不可少的技术能力。而TCV需要突破的核心技术在于微通孔的加工、实心孔的金属化、多层布线、陶瓷的三维堆叠等。另外,在共性技术和关键技术实现的基础上特别需要关注多个制程和工序的兼容性。TCV制作工艺流程采用并行方式实现多个单元的陶瓷薄膜电路加工,然后将各单元焊接叠装并测试整件性能。
TCV关键技术:
1)薄膜多层布线技术
薄膜多层布线技术实现的关键是具有稳定可靠的介质膜层和膜层表面形成稳定可靠的图形。2)介质微孔互连技术
在薄膜多层布线结构中,两个不同层间的互连工艺属于非填充型工艺,要求接触电阻小,无断路现象。3)陶瓷立体穿孔互连技术
TCV技术的3D方向堆叠通过不同层级基片间陶瓷穿孔互连实现。传统薄膜工艺通常采用激光打孔后溅射金属化的方法制备空心接地孔。此方法无法满足TCV层间的倒装焊植球、高频信号传输等要求。采用印刷填孔和电镀填充两种方案可实现陶瓷立体互连通孔。在TCV工艺中可采用深孔电镀方式对通孔进行填充,其具有通孔气密、导电性优良的特点。4)TCV板级三维焊接技术
TCV板级三维焊接技术中首先应确认合理的焊接材料、焊盘设计加工以及焊接工艺方法参数等。根据基板面积大小的不同,可选用焊球凸点焊接和焊盘对接两种方法实现。另外,在多级焊接中,应根据工艺流程兼容性要求选择不同熔化温度的焊料实现梯度焊接。TCV技术可将芯片和功能基板进行垂直互连,实现宽带射频功能单元以及系统的微型化,是系统2.5D和3D异构集成的关键技术之一。来源:陶瓷穿孔三维互连(TCV)技术研究,秦跃利,等.11月22日,第二届陶瓷封装产业论坛将于石家庄举办,届时,武汉利之达科技创始人、华中科技大学陈明祥教授将出席并做主题报告,重点介绍陶瓷转接板(TCV)技术研发、产业化及其系统级封装应用(包括功率半导体、高温电子器件等),以及相关技术发展等。原文始发于微信公众号(艾邦陶瓷展):一文了解陶瓷穿孔三维互连(TCV)技术